OVERVIEW
유전체 확산 방지막
유전체 확산 방지막
유전체 확산 방지막(Dielectric Diffusion Barrier)
현재 반도체 소자의 전기적 상호작용을 위해 사용되는 구리 배선(Cu interconnect)은 기존 알루미늄(Al) 배선에 비해 집적화에 유리하였지만 확산성이 높아 층간절연막 내부로 침투할 수 있다는 문제점이 있다. 구리가 절연막 내부로 침투하면 절연파괴가 일어나 소자불량을 야기할 수 있기 때문에 구리 배선 공정에서는 구리 확산을 막기 위한 확산방지막의 배치가 필수적이다. 배선의 측면과 하부에는 금속 계열인 탄탈륨/탄탈륨질화물(Ta/TaN) 이중막이 확산방지막으로서 사용되고 있으며, 배선의 상부에는 여러 보호 목적으로 증착되는 유전체 캡핑층(capping layer)이 확산방지막 역할을 한다.
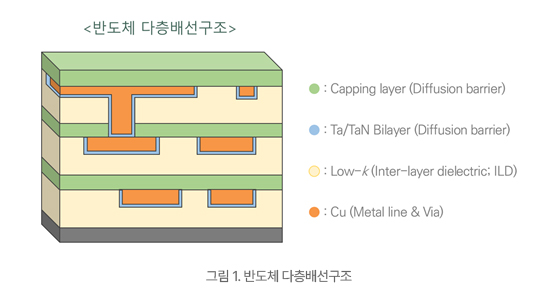
초기 기술 노드에서는 상부 확산 방지막으로 실리콘질화물(SiN)을 주로 사용하였다. SiN은 비교적 기계적 안정성이 우수하고 구리와의 계면 안정성도 좋아 배선 보호에 효과적이지만, 유전상수(k)가 약 7로 비교적 높아 배선 사이 기생 커패시턴스를 크게 증가시켰다. 그 결과 저항-커패시턴스 지연(RC delay)이 증가하여 소자의 성능 저하를 유발하였고 이러한 문제는 집적화가 진행될수록 더욱 크게 대두되었다. 이러한 문제를 개선하기 위해 현재 산업계에서는 SiN 대신 실리콘탄소질화물(SiCN)을 구리 상부에 유전체 확산방지막으로 사용하고 있다. SiCN은 유전상수가 약 5로 SiN보다 낮아 배선 간 기생 커패시턴스를 줄일 수 있고, 막질의 응력을 조절하여 계면 안정성 및 기계적 안정성도 확보할 수 있다.
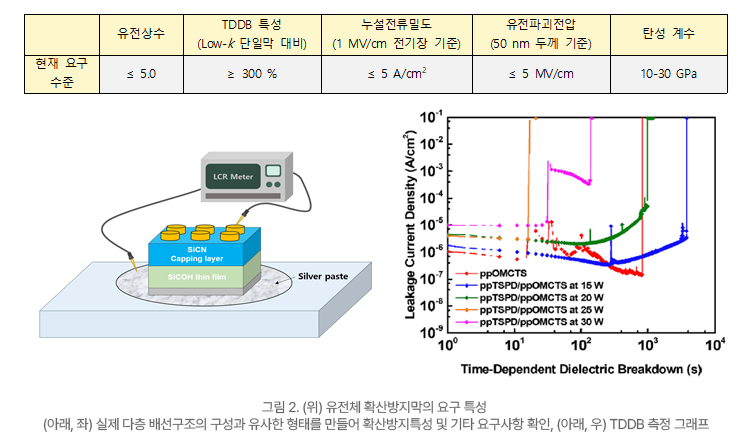
결과적으로, 현재 SiCN은 구리 상부에 적용되는 유전체 확산방지막의 표준으로 자리잡았으며 더욱 고도화되고 있는 반도체 소자 집적화 흐름에 따라 더 나은 성능을 가진 SiCN의 개발이 꾸준히 요구되고 있다.
